(T-ESC®成员)
PR HT T-ESC®
等离子高温静电夹具(PR HT T-ESC®)是我们为等离子和离子注入加工过程中的薄晶圆持取支持而特别设计的解决方案。 因此,晶圆始终牢固地夹持在 PR HT T-ESC 顶部,此外 HT T-ESC 系列与工艺腔室内现有的固持静电夹盘解决方案兼容,具有非常高的传热率,因此器件晶圆在加工过程中仍然可以冷却。 它基于我们的 特殊设计HT T-ESC®,可以避免 T-ESC® 与等离子/离子轰击之间相互作用。
PR HT T-ESC®
典型应用
-
等离子和离子注入工艺中的薄晶圆持取支持解决方案
-
与现有的持取系统兼容(传送匣盒、真空、伯努利或机械末端夹持器)
-
超低污染
-
高平整度
-
无放气
-
可重复使用
-
尺寸从 2" 到 12",或用户定制
推荐工艺:
-
离子注入
-
化学气相沉积(CVD)/等离子体增强化学气相沉积(PECVD)
-
物理气相沉积(PVD/ 溅射
-
等离子清洗
-
深槽离子刻蚀(DRIE)/反应离子刻蚀(RIE)
-
电镀
-
持取
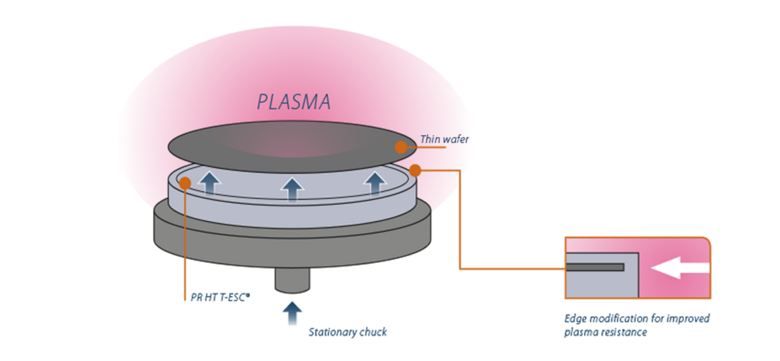
用离子轰击基板,离子将停留在晶体结构内并形成掺杂区域。通常这仅在晶圆的特定部分中需要,因此其余部分被光罩覆盖并且离子的深度也可以受控。
化学气相沉积(CVD):化学气相沉积使用气体在基板上沉积膜层。根据 CVD 的具体类型,采用不同的温度和材料,最终形成根据 CVD 类型密度和稳定性变化的膜层。温度越高,膜层性能越好,通常工艺过程时间更长,但并非所有基板材料或已经构建的结构都能承受高温。因此,需要对基板进行冷却或选择低温 CVD 工艺类型。 等离子体增强化学气相沉积(PECVD):等离子体增强化学气相沉积通常采取低于纯化学气相沉积工艺的温度,用等离子体激活反应气体,然后将其沉积在基板上。
基本上从固相或液相开始强制进入气相并再次形成固体的过程称为物理气相沉积。溅镀是其中最著名的工艺。离子加速撞击靶材,离子轰击产生来自靶材的自由粒子,这些粒子在基板上形成共形膜层。根据靶材和所需的层特性,溅镀工艺有不同的方法,例如通过将反应气体添加到腔体中,靶材和气体组合在基板上形成膜层。另一种选择是加热材料直到进入气相,然后将其引导到目标基板,这称为蒸镀。
等离子清洗或去胶通常用于清洗基板表面上的抗蚀剂残留物或其他污染物。气体被电离并与形成胶的抗蚀剂反应,胶通过真空泵泵出腔体。
反应离子刻蚀是一种将离子加速到基板上,撞击表面并产生自由粒子的工艺。根据所选择的气体,离子对不同的材料更具反应性,从而产生选择性工艺。然而,离子轰击造成损害,随后进行愈合。 深反应离子刻蚀通常是刻蚀和钝化层的混合物,以产生深而尖锐的孔或柱。刻蚀和钝化按顺序进行。
电镀是一种从液相中形成膜层到基板上的方法。预期区域被光罩掩盖并将基板浸没,通常覆盖背面,通过在基板和液体之间施加电场,在基板的未覆盖表面上形成膜层。